
資訊中心NEWS CENTER
在發展中求生存,不斷完善,以良好信譽和科學的管理促進企業迅速發展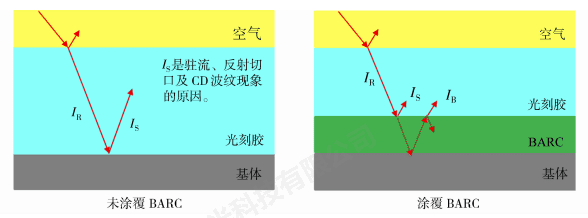
圖1.有無底部抗反射層BARC效果對比
抗反射涂層量測意義及方案
抗反射涂層本質在于通過材料本身光學常數與厚度的共同作用來調節降低反射率。因此,在光刻工藝中,精確量測抗反射涂層(ARC)的光學常數(折射率n和消光系數k)與厚度有著至關重要的意義。
抗反射涂層的量測手段以光學測量技術為主:橢偏儀作為一種非接觸、高精度的光學測量儀器,通過測量光經過樣品前后的偏振態變化來計算薄膜的光學常數與膜厚均勻性;膜厚儀則通過測量光的干涉原理,從而快速、精確計算得到膜厚分布。
1.光學常數(n/k值)
抗反射涂層的光學常數決定了涂層可實現的理論反射率。橢偏儀能夠快速、準確地獲取全波段(如193–1650 nm)n/k 曲線,為工藝優化提供數據支撐。
2.膜厚與均勻性
抗反射涂層厚度的微小偏差會引發區域反射率不均,進而影響產品良率和性能一致性。橢偏儀通過二維平面Mapping掃描功能,可精確測量膜厚分布,從而有效保障工藝均勻性和穩定性。
3.多層結構解析
針對ARC+PR、Tri-layer等多層膜系,橢偏儀可通過分層建模,精確測量各層的厚度信息,解決膜層之間相互干擾的難題。
推薦產品
針對光刻領域,首要推薦頤光科技ME-Mapping自動掃描型橢偏儀,可以滿足2-12寸晶圓的多點掃描測量需求,支持實時顯示膜厚分布以及數據匯總。設備采用雙旋轉補償器調制技術,結合精密的光路校準算法,直接測量16個全穆勒元素,可精確表征薄膜的膜厚、光學常數及介電函數等。

圖2.ME-mapping
測量案例與數據分析
一、單點測量無機抗反射層SiON
1)對Si基底上SiON涂層進行建模測量,其結構示意圖見圖4。

圖3.Si-SiON樣品簡化模型
Si-SiON的橢偏光譜擬合結果如圖5所示。
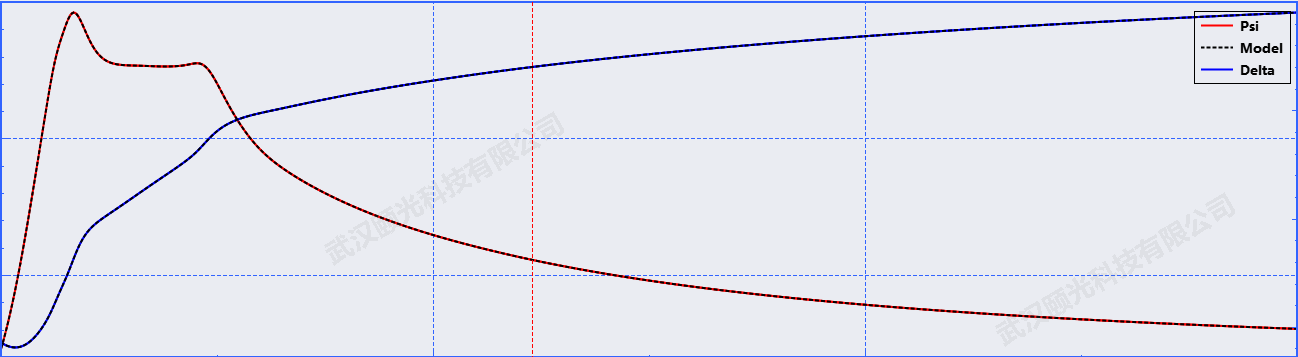
圖4.Si-SiON的擬合結果
2)對Si-SiON-Resist涂層進行建模測量,其結構示意圖見圖6。

圖5.Si-SiON-Resist樣品簡化模型
Si-SiON-Resist的橢偏光譜擬合結果如圖7所示。

圖6.Si-SiON-Resist的擬合結果
二、Mapping掃描測量BARC/BARC+PR
1)對Si基底上BARC涂層進行建模測量,其結構示意圖見圖8。

圖7.Si基底上BARC樣品簡化模型
橢偏擬合光譜曲線如圖9所示;同時,通過頤光科技的ME-mapping儀器測量可以準確反映出樣件表面的厚度熱力圖,如圖10所示,厚 度滿足客戶工藝預期。
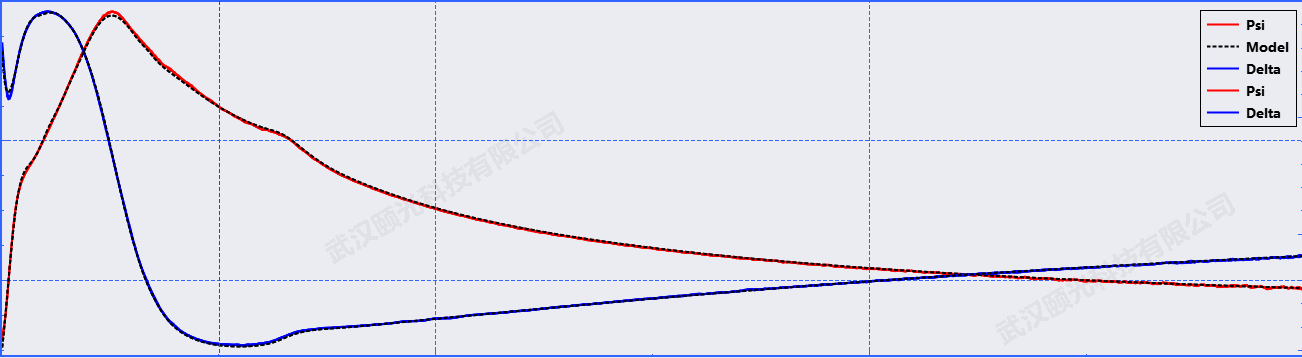
圖8.BARC涂層樣品橢偏儀擬合光譜

圖9.BARC涂層的熱力分布圖
2)對BARC涂層上的光刻膠層進行建模測量,其結構示意圖見圖11。

圖10.Si-BARC-PR樣品簡化模型
Si-BARC-PR的橢偏光譜擬合結果如圖12所示。
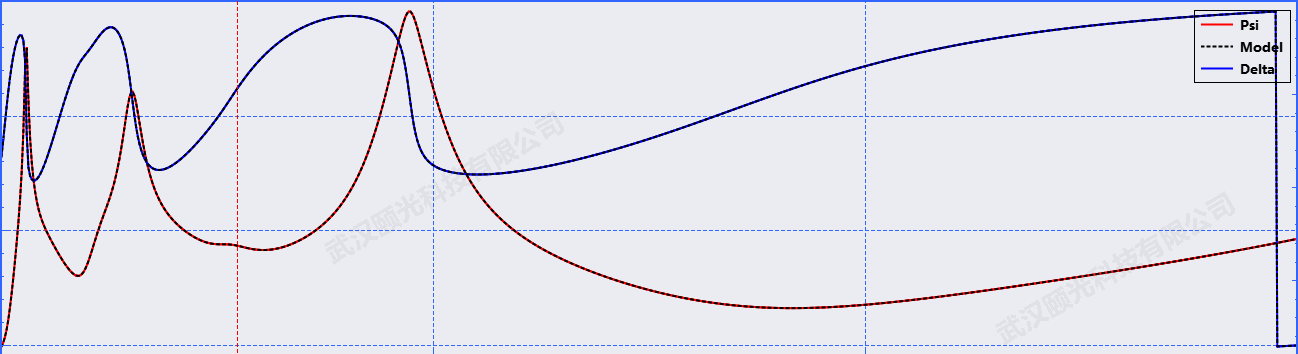
圖11.Si-BARC-PR的橢偏儀擬合光譜
橢偏儀支持分析測量多層膜結構,圖13為BARC+PR結構中BARC層厚度分布熱力圖,圖14為涂覆光刻膠前后BARC層的厚度差異熱力分布圖。BARC層在涂覆光刻膠前后厚度差異小于0.5nm,符合客戶工藝預期。圖15為PR層厚度分布熱力圖,厚度均勻性符合客戶工藝預期。

圖12.BARC涂層的熱力分布圖

圖13.涂覆光刻膠前后BARC涂層的厚度差異熱力分布圖

圖14.光刻膠層的厚度熱力分布圖
Copyright©2026 武漢頤光科技有限公司 版權所有 備案號:鄂ICP備17018907號-2 sitemap.xml 技術支持:化工儀器網 管理登陸